전체
반도체
반도체소재부품
반도체장비
차/전력반도체
후공정/기판
2차전지
2차전지소재
2차전지장비
폐배터리
자동차
자동차부품
디스플레이
전기전자
수소
신재생에너지
원자력
에너지/원자재
5G/통신
자율주행
AI/AR/VR
로봇
항공/우주/방위
UAM
철강
비철금속
화장품/유통
여행/카지노
음식료
의류신발
폐기물
플라스틱
미용/의료기기
조선/해운
인터넷/보안
게임
엔터/미디어
정유/화학
건설
기계/유틸
투자관련
경제/통계
기타
2025.4Q 분기별 매출액 성장 2025.4Q 분기별 영업이익 성장 2025.4Q 분기별 수주잔고 성장 2025.4Q 8주에 80%이상 상승 2025.4Q 신저가대비 100%이상 상승 2025.4Q 50일신고가+신저가대비 70%이상 2025.4Q 2주에 15%이상 하락 2025.4Q 반등강도(30~40)
2025.4Q 분기별 매출액 성장 2025.4Q 분기별 영업이익 성장 2025.4Q 분기별 수주잔고 성장 2025.4Q 8주에 80%이상 상승 2025.4Q 신저가대비 100%이상 상승 2025.4Q 50일신고가+신저가대비 70%이상 2025.4Q 2주에 15%이상 하락 2025.4Q 반등강도(30~40)
2021.08.17
레이저 다이싱 종류 / 웨이퍼 소잉 방식의 변화 / 웨이퍼가 얇아지는 이유
[삼성증권 배현기] 반도체 후공정: 달라지는 위상, 새로워질 평가
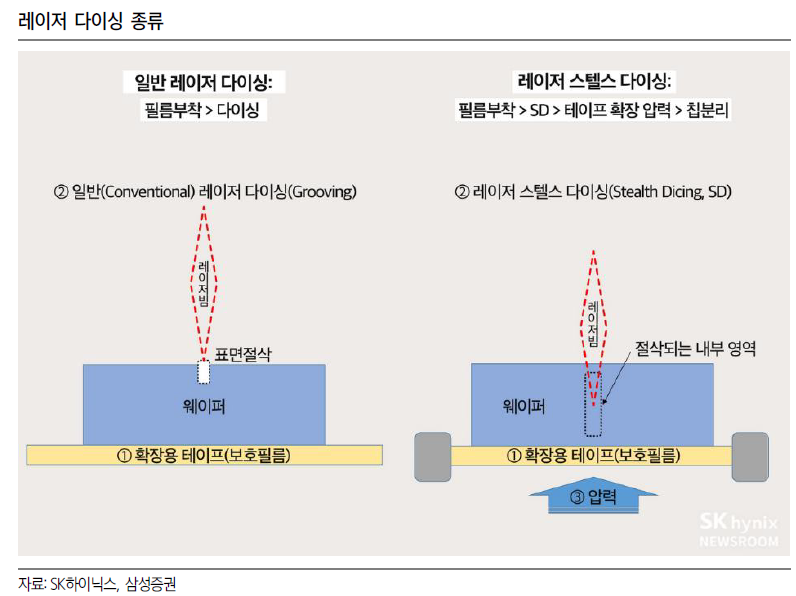

웨이퍼가 얇아질 필요성이 계속 커지며 레이저 다이싱의 비중이 커지고 있는 추세이다 . 아직까지 플라즈마 다이싱의 용처는 확대되기에는 단점이 많은 것으로 판단된다 따라서 레이저 다이싱의 비중 확대가 투자 아이디어로 더 활용 가능성이 높다고 생각된다.
* 웨이퍼가 얇아지는 이유
어플리케이션마다 웨이퍼가 얇아지는 이유는 다르다고 알려져 있다 .
파워디바이스 경우 두께를 줄이면 저항이 낮아지고 전류 전송 능력이 향상 , 전력소비량 최소화되는 장점이 존재한다. 메모리 반도체 경우 메모리용량 증가 , 데이터전송속도 향상 , 전력효율성이 요구되며 얇아지고 있는 트렌드이다. CIS 웨이퍼의 경우 TSV 패키잉을 위해 얇아지는 트렌드이며 , 반면 RF 는 140~200 μ m 범위에서 머물러 있다고 알려져 있다. 와이어본딩이나 플립칩 패키징이 더 폭넓게 채용되면서 웨이퍼 두께가 점점 두꺼워지고 있는 상황이다.
결론적으로, 웨이퍼가 얇아지는 이유는 결국은 성능향상이나 , 패키징 과정속에서 단차를 낮추기 위한 작업이라고 판단된다 . 특히나 적층구조의 패키징이 발전할수록 , 또한 적층하는 칩 개수가 많아질수록(2.5D/3D 패키징 구조 확대에 따라) 웨이퍼 두께가 얇아지는 트렌드는 지속될 것이라 추정된다
관련 목록
후공정/기판 목록