전체
반도체
반도체소재부품
반도체장비
차/전력반도체
후공정/기판
2차전지
2차전지소재
2차전지장비
폐배터리
자동차
자동차부품
디스플레이
전기전자
수소
신재생에너지
원자력
에너지/원자재
5G/통신
자율주행
AI/AR/VR
로봇
항공/우주/방위
UAM
철강
비철금속
화장품/유통
여행/카지노
음식료
의류신발
폐기물
플라스틱
미용/의료기기
조선/해운
인터넷/보안
게임
엔터/미디어
정유/화학
건설
기계/유틸
투자관련
경제/통계
기타
2025.4Q 분기별 매출액 성장 2025.4Q 분기별 영업이익 성장 2025.4Q 분기별 수주잔고 성장 2025.4Q 8주에 80%이상 상승 2025.4Q 신저가대비 100%이상 상승 2025.4Q 50일신고가+신저가대비 70%이상 2025.4Q 2주에 15%이상 하락 2025.4Q 반등강도(30~40)
2025.4Q 분기별 매출액 성장 2025.4Q 분기별 영업이익 성장 2025.4Q 분기별 수주잔고 성장 2025.4Q 8주에 80%이상 상승 2025.4Q 신저가대비 100%이상 상승 2025.4Q 50일신고가+신저가대비 70%이상 2025.4Q 2주에 15%이상 하락 2025.4Q 반등강도(30~40)
2021.08.11
웨이퍼레벨 패키징 (Wafer Level 패키징 /WL 패키징)
[삼성증권 배현기] 반도체 후공정: 달라지는 위상, 새로워질 평가

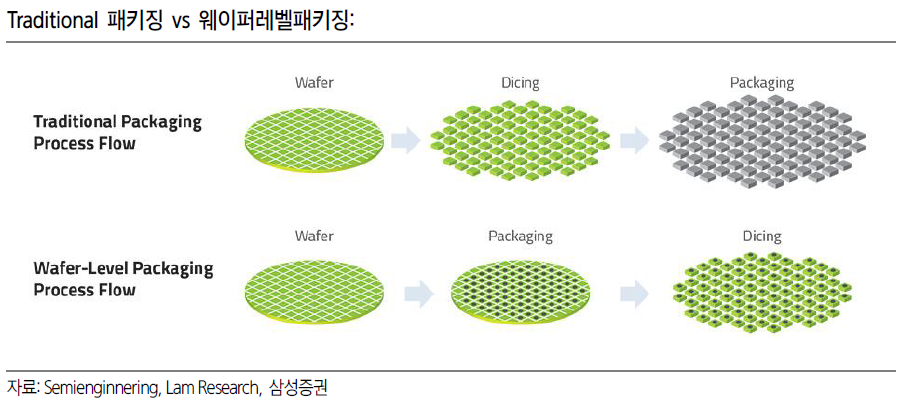
팬아웃 웨이퍼레벨패키징은 몰딩 이후 캐리어와 테이프를 분리시킨 뒤, 몰딩된 새로운 웨이퍼에 금속배선을 형성하고 패키지용 솔더볼을 부착한 뒤 패키지 단품으로 잘라 주는 방식이 이어진다. 더 미세한 배선이 필요한 경우에는 웨이퍼 형태의 캐리어에 먼저 금속 배선을 형성시킨 뒤 칩을 붙이고 몰딩 작업을 수행하는 방식을 거치는 것으로 알려져 있다. 즉, 팬인과 팬 아웃의 차이점은 RDL을 통합하는 방법이라고 볼 수 잇다. 팪읶에서 RDL은 내부로 라우팅되어 I/O 수를 제한하며, 팬 아웃은 RDL은 앞쪽과 바깥쪽이 라우팅되므로 더 많은 I/O이 가능한 구조이다. I/O이 많아져야 하는 이유는 딜레이를 줄여주고 전력소모를 감소시켜주기 때문이며 결국 패키징의 방향은 I/O의 수를 늘리기 위한 방향과 함께 고도화 되어가는 모습이다
관련 목록
후공정/기판 목록