2025.4Q 분기별 매출액 성장 2025.4Q 분기별 영업이익 성장 2025.4Q 분기별 수주잔고 성장 2025.4Q 8주에 80%이상 상승 2025.4Q 신저가대비 100%이상 상승 2025.4Q 50일신고가+신저가대비 70%이상 2025.4Q 2주에 15%이상 하락 2025.4Q 반등강도(30~40)
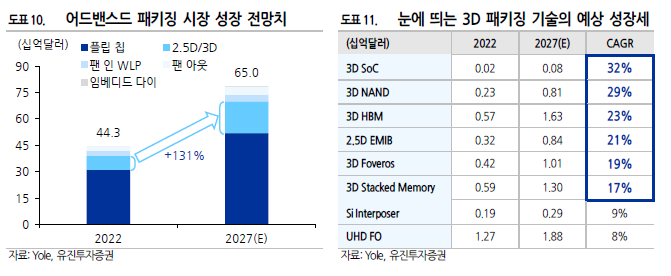


칩렛과 헤테로 인테그레이션 기술이 이끄는 어드밴스드 패키징 시장은 지난해 44 억달러 규모에서 2027 년 65 억달러로 확대될 것으로 예상된다. 이 시기에는 마이크로프로세서의 80%가 칩렛 방식으로 제조될 것으로 전망한다. 특히 2.5D와 3D 패키징 시장이 2 배 이상 성장할 것으로 예상되는 바, 관련된 서플라이 체인에 대한 관심은 계속 커지고 있다
기업별 반도체 후공정 투자 계획
인텔
인텔의 경우 가장 강도 높은 어드밴스드 패키징 투자를 진행하는 기업이라고 할 수 있다. 지난 5 월 약 47 억달러 규모의 투자를 발표하면서 2025 년 어드밴스드 패키징 캐파를 올해 대비 4 배 수준으로 확대할 계획을 밝혔다. 이에 따라 인텔은 첫 외부 거점이었던 말레이시아의 페낭 지역에 60 억달러 규모의 추가 팹을 건설할 예정이다.
TSMC
TSMC 의 경우 이미 어드밴스드 패키징 공정이 도입된 공장 5 개를 보유하고 있으나, 대만 내 3.7 조원 규모의 추가 투자를 발표했다. 엔비디아의 제품이 2024년까지 캐파의 40%를 차지할 것으로 예상되는 바, CoWoS 기술을 도입한 생산능력을 2024 년 말까지 월 2.8 만장으로 확대할 계획이다. 관련하여 OSAT 기업들인 ASE 와 Amkor 는 TSMC 의 제조 병목으로, 후공정 일부를 엔비디아로부터 직접 인증받아 빠르면 내년 상반기부터 생산할 예정이다.
삼성전자
국내 기업들 가운데 삼성전자는 올 한 해 2 조원 이상을 패키징 라인 증설에 투자하며 천안 사업장을 어드밴스드 패키징 투자 거점으로 계획하고 있다. SK 하이닉스도 미국 내 패키징 공장 신설을 위한 150 억달러 규모의 투자를 진행할 예정이다. 한편 국내 OSAT 기업인 하나마이크론은 베트남 공장을 증설하며 SK 하이닉스의 패키징과 테스트 공정을 진행할 것으로 예상된다.