2025.4Q 분기별 매출액 성장 2025.4Q 분기별 영업이익 성장 2025.4Q 분기별 수주잔고 성장 2025.4Q 8주에 80%이상 상승 2025.4Q 신저가대비 100%이상 상승 2025.4Q 50일신고가+신저가대비 70%이상 2025.4Q 2주에 15%이상 하락 2025.4Q 반등강도(30~40)



Hybrid Bonding 기술 발전의 방향성
Hybrid Bonding 이 갑작스레 탄생한 신생 기술은 아니다 과거 Wafer t o Wafer 기술을 기반으로 CMOS Image Sensor (SONY, 삼성전자 등 에 적용된 사례가 있고 YMTC 가 NAND 의 적층단수 확대를 위해 고안한 Xtacking 공법에 관련 기술을 적용된 바 있다.
현재는 Wafer to Wafer 를 너머 Die to Wafer 구조로 기술 진보가 나타나고 있다는 판단이다 Hybrid Bonding 이 가져올 수 있는 많은 기술적 이점들 전기밀도 향상 Interconnection 축소 등 을 감안해보면 이 기술의 Application은 향후 5년 내 높은 확장성을 보일 가능성이 크다. 지금은 CMOS Image Sensor 와 2.5D Packaging (현재 TSMC 의 CoWoS 에서 활용 중) 중심으로 활용되고 있으나 향후 HBM,NAND 등으로 Application 이 확대될 것으로 예상한다.
• HBM4 16 단 이상 제품군부터 적용 예상 : 2026~2027 년 양산 예정인 HBM4 부터 Hybrid Bonding 이 활용될 가능성이 높다는 판단이다 HBM4 의 경우 12 단과 16 단 2 가지 제품으로 양산이 이뤄질 것으로 예상되며 16 단 이상부터 Hybrid Bonding 기술이 본격적으로 적용될 것으로 예상한다
• NAND로의 확장 가능성도 열려 있다 는 판단 : 300단 이상부터 NAND Stacking이 재차 늘어날 것으로 예상된다 Double Stacking 에서 Triple Stacking 으로 확대될 것으로 예상되고 Stacking 의 난이도도 투자 부담도 막대하게 커질 것으로 예상된다 비용 부담이 커지는 만큼 대체 솔루션에 대한 연구개발이 진행 중이며 이에 대한 솔루션으로 Hybrid Bonding 기술의 도입 이 검토될 가능성이 있다는 판단이다
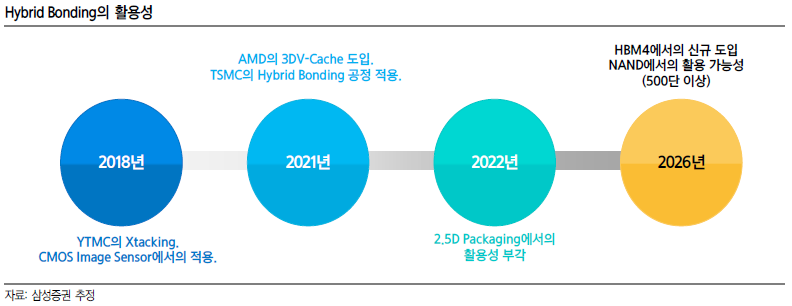
HBM 으로의 적용 : 좋은 기술이나 아직은 시간이 필요하다는 판단
현재까지의 기술 로드맵 상 HBM에 적용되는 시점은 2026년 내외일 것이라는 판단이다. 현재 주요 제조사들의 경우 HBM4 부터 Hybrid Bonding 을 적용할 계획을 가지고 있는 것으로 추정된다.
• SK하이닉스의 경우 2026~2027년 출시 예정인 HBM4 부터 Hybrid Bonding 을 적용할 것으로 추정된다. HBM4 의 경우 12 단과 16 단 제품으로 개발이 될 것으로 예상되며 16 단 제품에 한정하여 Hybrid Bonder가 활용될 것이라는 판단이다
• 삼성전자와 Micron Technology 역시 HBM4 부터 Hybrid Bonding 을 적용할 것으로 예상한다
기술 변화 트렌드 상 Hybrid Bonding이 HBM 기술 패권 장악의 열쇠가 될 가능성이 높다고 생각한다. 하지만 기술이 가져올 수 있는 순기능이 큰 만큼 활용하기도 어렵다는 판단이다. Middle Chip, Dishing 및 Particle Control 등이 어렵고 , 관련 기술의 추가적인 Upgrade가 필요한 것으로 추정된다.